1. TSV packaging technology
■ Inter-chip interconnection and high-density stacking in three dimensions
■ Increase product signal transmission speed
■ Reduce internal power consumption
■ Achieve the highest performance and the smallest form factor
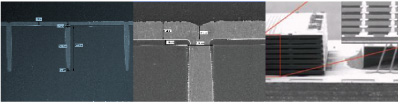
2.SiP RF packaging technology
■ RF technology can be widely used in wireless communication, identification and other fields, and the market prospect is very broad.

3. Wafer-level 3D rewiring packaging technology
■ Through the re-wiring design, the original irregularly arranged I / O electrodes are arrayed.

4. Copper bump interconnect technology
■ Suitable for high density, high power packaging

5, high-density FC-BGA packaging and testing technology
■ Significantly reduce costs and volume of products

6. Multi-turn array four-side leadless packaging and testing technology
■ A new packaging technology that replaces traditional packages below 500 pins
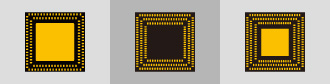
7.Three-dimensional three-dimensional stacking technology for packages
■ Fully save the PCB area occupied by the product and reduce signal interference.

8.Three-dimensional three-dimensional stacked packaging technology for ultra-thin chips below 50μm
■ Ultra-thin wafer ultra-thin grinding technology
■ Ultra-thin wafer slicing technology
■ Ultra-thin chip stacking technology
■ Ultra-thin multilayer chip wiring technology
■ Multi-layer chip ultra-thin encapsulation technology

9.MEMS multi-chip packaging technology
■ MEMS wafer mounting technology
■ MEMS wafer cutting technology
■ MEMS product placement technology
■ MEMS chip wiring technology
■ Coating technology for MEMS products
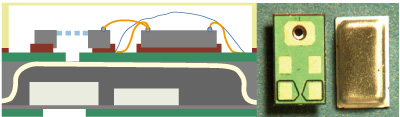
 简体中文
简体中文 English
English


